Waferritzen mit dem Laser macht Wafersägen überflüssig
Wafer werden vom Laser mit 300 bis 700 Millimeter pro Sekunde geritzt – so schnell ist keine Säge
Wafer sind die kreisrunden oder quadratischen hauchdünnen Scheiben, die in der Photovoltaik, Mikroelektronik oder Mikrosystemtechnik als Bauplatte dienen. Häufig werden vor allem Chips im Verbund gefertigt. Diese Chips müssen vor ihrer Weiterverarbeitung als Einzelchips zur Verfügung gestellt werden. Bei Siliziumwafern oder Wafern, die als Halbleiter verarbeitet werden, sind bereits im Herstellungsprozess winzige Trennrahmen zwischen den einzelnen Chips eingefügt worden. Dieser schmale Bereich wird beim Waferritzen zerstört. Um die einzelnen Chips flächig weiterzuverwenden, werden die Scheiben vor dem Waferritzen auf eine klebende Folie, in der Regel die sogenannte Blaufolie, geklebt. Die Folie muss bestimmte Eigenschaften mitbringen, um für diesen Zweck geeignet zu sein, so wird sie beispielsweise im Reinraum gefertigt.
Trennung durch Waferritzen mit Laser, Diamant oder Säge?
Zu den herkömmlichen Verfahren für die Trennung der Wafer gehört das Waferritzen mit einer Diamantspitze. Diese wird unter leichtem Druck über die Ritzbereiche geführt und so eine minimale Vertiefung erzeugt. Auf diese Weise entstehen gewollte Defekte und Spannungen im Kristallgitter der Wafer, die dann bei geringen Belastungen an der geritzten Stelle brechen. Je dicker allerdings der Wafer wird, um so schwieriger wird das Waferritzen mit dem Diamant. Darüber hinaus entstehen durch das Ritzen und anschließende Brechen der Wafer unsaubere Kanten, die bei einer Weiterverarbeitung das Greifen der einzelnen Chips erschweren.
Beim Trennsägen der Wafer werden diamantbesetzte Trennscheiben entlang der Trennlinien geführt. Da bei diesem Verfahren Siliziumstaub entsteht, müssen die Wafer anschließend durch Flüssigkeitsspülungen gereinigt werden.
Das Waferritzen mit dem Laser beseitigt diese Probleme. Selbst dicke Wafer können leicht und mit exakten Kanten getrennt werden. Beim anschließenden Dehnen der Blaufolie lassen sich die Chips gut greifen und sauber weiter verarbeiten. Im Gegensatz zum mechanischen Ritzen wird beim Waferritzen mit dem Laser das Material im Ritzbereich lokal begrenzt geschmolzen. Es kristallisiert dadurch zu polykristallinem Silizium. Dabei entstehen im Material die gewollten Spannungen, die das Brechen fördern.
Waferritzen mit dem Laser ist kostengünstig, wesentlich zeitsparender als herkömmliche Verfahren und kommt ohne Ätz- oder Spülflüssigkeiten aus. Lassen Sie sich überzeugen – wir beraten Sie gerne. Schicken Sie uns eine Mail an info@gkteso.de.

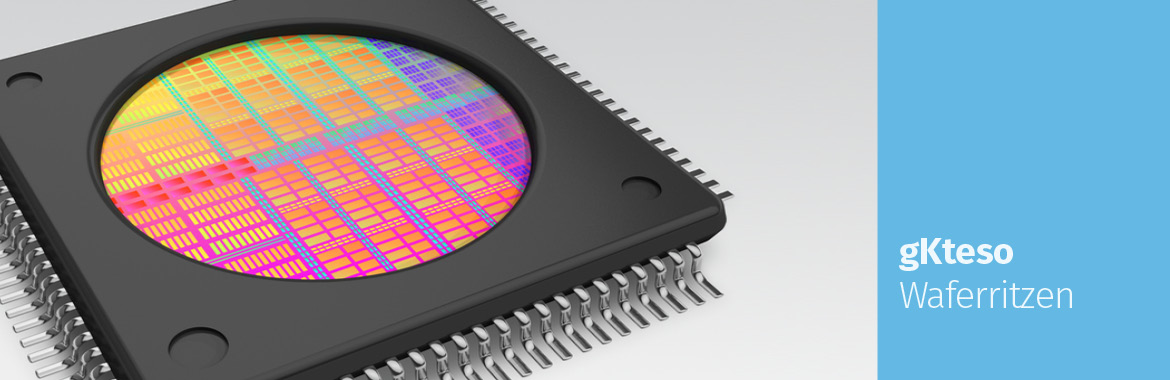

 Download Datenblätter
Download Datenblätter